- VLSI设计-MOS逆变器(1)
- VLSI设计-顺序MOS逻辑电路
- VLSI设计-顺序MOS逻辑电路(1)
- VLSI设计教程
- VLSI设计教程(1)
- 讨论VLSI设计
- VLSI设计-数字系统(1)
- VLSI设计-数字系统
- VLSI设计-有用的资源
- VLSI设计-有用的资源(1)
- 晶体管 (1)
- VLSI设计-Verilog简介(1)
- VLSI设计-Verilog简介
- VLSI设计-VHDL简介
- VLSI设计-VHDL简介(1)
- 晶体管 - 任何代码示例
- 晶体管字符 (1)
- VLSI设计-FPGA技术
- VLSI设计-FPGA技术(1)
- 晶体管工作区
- 晶体管工作区
- 晶体管配置
- 晶体管的配置
- 晶体管-概述
- 晶体管-概述(1)
- 晶体管字符 - 任何代码示例
- 晶体管的构造
- 组合MOS逻辑电路
- 晶体管负载线分析
📅 最后修改于: 2020-11-22 17:11:39 🧑 作者: Mango
如今,互补MOSFET(CMOS)技术已广泛用于在众多不同的应用中形成电路。由于一些关键优势,当今的计算机,CPU和手机都使用CMOS。 CMOS在两种状态下均具有低功耗,相对较高的速度和较高的噪声容限,并且可在宽范围的电源电压和输入电压下工作(前提是电源电压是固定的)
对于我们将要讨论的过程,可用的晶体管类型是金属氧化物半导体场效应晶体管(MOSFET)。这些晶体管形成为“三明治”,由单晶硅晶体的半导体层(通常是切片或晶片)组成;一层二氧化硅(氧化物)和一层金属。
MOSFET的结构
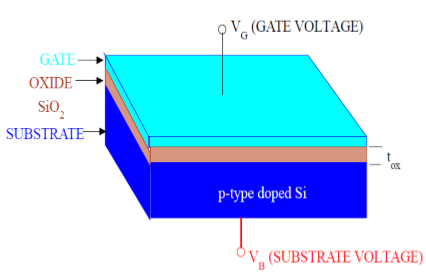
如图所示,MOS结构包含三层-
-
金属栅电极
-
绝缘氧化物层(SiO 2 )
-
P型半导体(基板)
MOS结构形成电容器,栅极和衬底为两块板,氧化层为介电材料。电介质材料(SiO 2 )的厚度通常在10nm至50nm之间。可以通过施加到栅极和衬底端子的外部电压来控制衬底内的载流子浓度和分布。现在,要了解MOS的结构,首先要考虑P –型半导体衬底的基本电性能。
载流子在半导体材料中的浓度始终遵循质量行为法则。群众行动法由-
$$ np = n_ {i} ^ {2} $$
哪里,
-
n是电子的载流子浓度
-
p是空穴的载流子浓度
-
n i是硅的本征载流子浓度
现在,假定衬底均被掺杂了受主(硼)浓度N A。因此,p型衬底中的电子和空穴浓度为
$$ n_ {po} = \ frac {n_ {i} ^ {2}} {N_ {A}} $$
$$ p_ {po} = N_ {A} $$
在此,掺杂浓度N A比本征浓度ni大(10 15至10 16 cm -3 )。现在,要了解MOS结构,请考虑p型硅衬底的能级图。
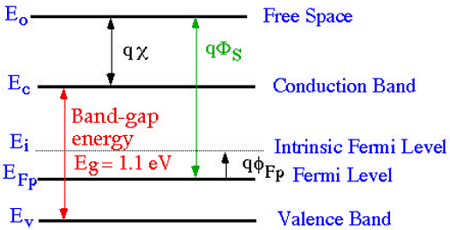
如图所示,导带与价带之间的带隙为1.1eV。这里,费米电势ΦF是征费米能级(E i)和费米能级(E FP)之间的差。
费米能级E F取决于掺杂浓度。费米电势ΦF是征费米能级(E i)和费米能级(E FP)之间的差。
数学上
$$ \ Phi_ {Fp} = \ frac {E_ {F} -E_ {i}} {q} $$
导带和自由空间之间的电势差称为电子亲和力,用qx表示。
因此,需要一个电子从费米能级的自由空间移动能量称为功函数(qΦS),它是由下式给出
$$ q \ Phi _ {s} =(E_ {c} -E_ {F})+ qx $$
下图显示了组成MOS的组件的能带图。
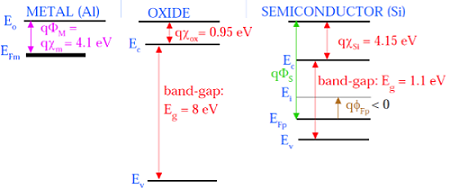
如上图所示,绝缘SiO 2层的能带隙为8eV,功函数为0.95eV。金属栅极的功函数为4.1eV。在这里,功函数不同,因此会在MOS系统上产生电压降。下图显示了MOS系统的组合能带图。
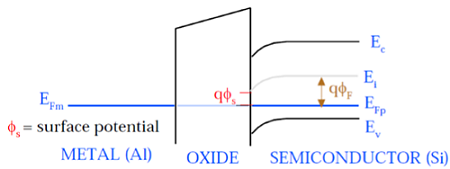
如该图所示,金属栅极和半导体(Si)的费米电位处于相同的电位。在表面费米电势被称为表面电位ΦS和它在幅值上比费米电势Φ˚F小。
MOSFET的工作
MOSFET由一个MOS电容器组成,该MOS电容器的两个pn结靠近沟道区域放置,该区域由栅极电压控制。为了使两个pn结反向偏置,衬底电势应保持低于其他三个端子电势。
如果栅极电压增加到超过阈值电压(V GS > V TO ),则将在表面上形成反型层,并且在源极和漏极之间形成n型沟道。该n型通道将根据V DS值传输漏极电流。
对于不同的V DS值,MOSFET可以在不同区域工作,如下所述。
线性区域
在V DS = 0时,反向沟道区域中存在热平衡,漏极电流I D =0。现在,如果施加较小的漏极电压,V DS > 0,则与V DS成比例的漏极电流将开始从源极流向通过通道排水。
该通道为电流从源极到漏极的流动提供了连续的路径。这种操作模式称为线性区域。下图显示了在线性区域工作的n沟道MOSFET的截面图。
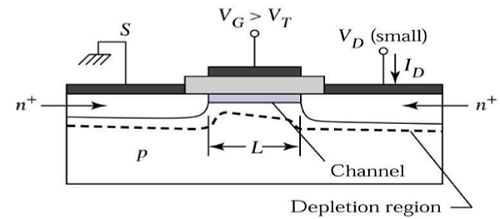
在饱和区域的边缘
现在,如果V DS增大,则在漏极结束时,沟道中的电荷和沟道深度减小。对于V DS = V DSAT ,通道中的电荷减少为零,这称为收缩点。下图显示了在饱和区边缘工作的n沟道MOSFET的截面图。
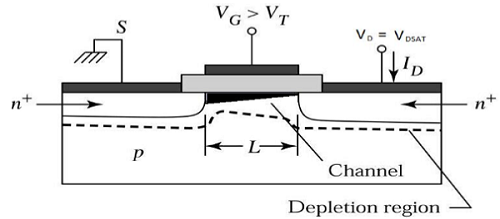
饱和区
对于V DS > V DSAT ,在漏极附近形成耗尽表面,并且通过增加漏极电压,该耗尽区扩展到源极。
这种操作模式称为饱和区域。从源极到沟道末端的电子进入漏极-耗尽区,并在高电场中朝着漏极加速。
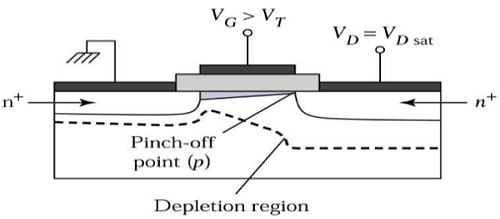
MOSFET电流–电压特性
为了了解MOSFET的电流-电压特性,需要对通道进行近似。没有这种近似,MOS系统的三维分析将变得复杂。电流-电压特性的渐进通道近似(GCA)将减少分析问题。
渐进通道近似(GCA)
考虑以线性模式工作的n沟道MOSFET的截面图。在此,源极和基板接地。 V S = V B =0。栅极到源极(V GS )和漏极到源极电压(V DS )电压是控制漏极电流I D的外部参数。
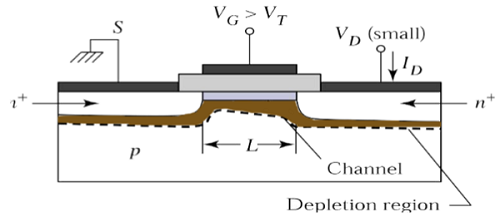
电压V GS被设置为大于阈值电压V TO的电压,以在源极和漏极之间形成沟道。如图所示,x方向垂直于曲面,y方向平行于曲面。
如图所示,在源端,y = 0。相对于源极的沟道电压由V C(Y)表示。假设阈值电压VTO沿着沟道区域在y = 0到y = L之间恒定。沟道电压V C的边界条件为-
$$ V_ {c} \ left(y = 0 \ right)= V_ {s} = 0 \,并且\,V_ {c} \ left(y = L \ right)= V_ {DS} $$
我们还可以假设
$$ V_ {GS} \ geq V_ {TO} $$和
$$ V_ {GD} = V_ {GS} -V_ {DS} \ geq V_ {TO} $$
令Q1(y)为表面反型层中的总移动电子电荷。该电子电荷可以表示为-
$$ Q1(y)=-C_ {ox}。[V_ {GS} -V_ {C(Y)}-V_ {TO}] $$
下图显示了表面反型层的空间几何形状,并指出了其尺寸。当我们从漏极转移到源极时,反型层逐渐变细。现在,如果我们考虑沟道长度L的小区域dy,则该区域提供的增量电阻dR可以表示为-
$$ dR =-\ frac {dy} {w。\ mu _ {n} .Q1(y)} $$
在此,负号是由于反型层的电荷Q1的负极性和μn是表面迁移率,这是不变的。现在,用dR公式替换Q1(y)的值-
$$ dR =-\ frac {dy} {w。\ mu _ {n}。\ left \ {-C_ {ox} \ left [V_ {GS} -V_ {C \ left(Y \ right)} \ right ] -V_ {TO} \ right \}} $$
$$ dR = \ frac {dy} {w。\ mu _ {n} .C_ {ox} \ left [V_ {GS} -V_ {C \ left(Y \ right)} \ right] -V_ {TO} } $$
现在小dy区域的电压降可以给出
$$ dV_ {c} = I_ {D} .dR $$
将dR的值放在上式中
$$ dV_ {C} = I_ {D}。\ frac {dy} {w。\ mu_ {n} .C_ {ox} \ left [V_ {GS} -V_ {C(Y)} \ right] -V_ {TO}} $$
$$ w。\ mu _ {n} .C_ {ox} \ left [V_ {GS} -V_ {C(Y)}-V_ {TO} \ right] .dV_ {C} = I_ {D} .dy $$
为了获得整个沟道区域上的漏极电流ID,可以将上述等式沿从y = 0到y = L且电压V C(y) = 0到V C(y) = V DS的沟道进行积分,
$$ C_ {ox} .w。\ mu _ {n}。\ int_ {V_ {c} = 0} ^ {V_ {DS}} \ left [V_ {GS} -V_ {C \ left(Y \ right )}-V_ {TO} \ right] .dV_ {C} = \ int_ {Y = 0} ^ {L} I_ {D} .dy $$
$$ \ frac {C_ {ox} .w。\ mu _ {n}} {2} \ left(2 \ left [V_ {GS} -V_ {TO} \ right] V_ {DS} -V_ {DS} ^ {2} \ right)= I_ {D} \ left [L-0 \ right] $$
$$ I_ {D} = \ frac {C_ {ox}。\ mu _ {n}} {2}。\ frac {w} {L} \ left(2 \ left [V_ {GS} -V_ {TO} \ right] V_ {DS} -V_ {DS} ^ {2} \ right)$$
对于线性区域V DS
$$ I_ {D} = C_ {ox}。\ mu _ {n}。\ frac {w} {2} \ left(\ frac {\ left [2V_ {DS} \ right] V_ {DS} -V_ { DS} ^ {2}} {L} \ right)$$
$$ I_ {D} = C_ {ox}。\ mu _ {n}。\ frac {w} {2} \ left(\ frac {2V_ {DS} ^ {2} -V_ {DS} ^ {2} } {L} \ right)$$
$$ I_ {D} = C_ {ox}。\ mu _ {n}。\ frac {w} {2} \ left(\ frac {V_ {DS} ^ {2}} {L} \ right)$$
$$ I_ {D} = C_ {ox}。\ mu _ {n}。\ frac {w} {2} \ left(\ frac {\ left [V_ {GS} -V_ {TO} \ right] ^ { 2}} {L} \ right)$$